西安電子科技大學郝躍院士、馬曉華教授團隊---探究 β-Ga?O? SBD 在正向電應力下的退化機制
由西安電子科技大學的研究團隊在學術期刊 Applied Physics Letters 發布了一篇名為 Forward bias stress-induced degradation mechanism in β-Ga2O3 SBDs: A trap-centric perspective(正向偏壓應力誘導的 β-Ga2O3 SBD 降解機制: 以陷阱為中心的視角)的文章。該篇文章為編輯精選(Editor’s Pick)文章。
1. 項目支持
該項研究得到了中國國家重點研發計劃(Grant No. 2023YFB3611902)、國家自然科學基金(Grant Nos. 62104180、U2241220 和 62421005)、陜西省自然科學基礎研究計劃(Grant No. 2023-JCQN-0669)以及國家輻射應用創新中心基金(Grant No. KFZC2022020401)的支持。
2. 背景
β-Ga2O3 由于其寬禁帶(4.5~4.9 eV)和高擊穿場強(~8 MV/cm)等優異特性,已成為包括肖特基勢壘二極管(SBD)在內的大功率電子器件的理想材料。然而,SBD 在正向偏壓應力作用下容易發生降解,影響其長期可靠性。本研究旨在探討 FBS 誘導的 β-Ga2O3 SBDs 退化機制,重點關注與陷阱(trap)相關的物理過程。
3. 文章摘要
該研究從缺陷演變的角度探討了恒定正向電應力對β-氧化鎵(β-Ga2O3)肖特基勢壘二極管(SBD)的影響。長時間的應力顯著增加了反向漏電流密度(JR)和小偏壓下的正向電流密度(JF),并降低了開啟電壓(Von)。溫度依賴的電流 - 電壓(I-V-T)分析表明,新鮮和受應力的 SBD 的反向漏電流均由波爾 - 弗倫克爾(PF)發射主導,而正向電流傳輸機制在受應力后從熱電子發射(TE)轉變為陷阱輔助隧穿(TAT)。深能級瞬態譜(DLTS)結果確定了β-Ga2O3 漂移層內一個本征陷阱 E2*(Ec - 0.75 eV),這很可能是與鎵空位相關的陷阱。該能級與 PF 障壁的一致性證明了該陷阱濃度的增加是 JR 增加的主要原因。空間分布特征表明,金屬 - 半導體界面附近陷阱濃度的增加遠大于體內的增加,這確立了該陷阱與小偏壓下的 JF 和 Von 之間的關聯。這些發現突顯了陷阱演變在 SBD 電應力下性能退化中的關鍵作用。
4. 創新點
•通過系統性的實驗分析,首次明確了 β-Ga2O3 SBD 在 FBS 作用下的陷阱演變機制。
•采用 DLTS 技術檢測到特定陷阱能級,揭示了正向偏壓應力誘導的界面態和體缺陷變化。
•提出了一個基于陷阱充電和釋放的退化模型,解釋了 β-Ga2O3 SBD 退化的關鍵物理過程。
•研究結果可為提高 β-Ga2O3 SBDs 的長期穩定性和可靠性提供指導。
5. 結論
該研究探討了 β-Ga2O3 SBD 在正向電應力下的退化機制。隨著應力時間的增加,反向電流和小偏壓下的正向電流均增加,開啟電壓降低。通過深入研究導電機制和陷阱特性(采用 DLTS 測量),我們發現與 EC-0.75 eV 處的 VGa 相關的陷阱 E2* 增加,導致以 PF 發射機制為主的反向電流增加。靠近金屬-半導體界面處陷阱濃度的更顯著增加,有效降低了等效肖特基勢壘高度,從而增加了小偏壓下的正向電流,并導致開啟電壓的負向漂移。有趣的是,觀察到了從界面延伸的準指數陷阱分布,并將其與 β-Ga2O3 SBD 電學性能的退化相關聯。本研究建立了陷阱濃度、陷阱空間分布與器件性能隨應力時間變化的關系,為提高 β-Ga2O3 SBD 的可靠性提供了有價值的見解。
6. 圖文內容
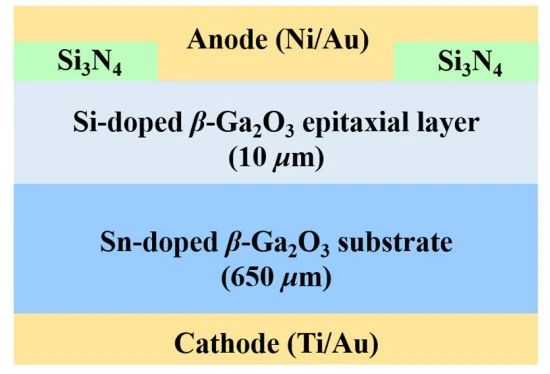
圖 1. 場板結構 β-Ga2O3 SBD 的橫截面示意圖。

圖 2. (a) 正向偏壓應力期間的半對數縮放 J-V 圖和 (b) 線性縮放 J-V 圖。插圖:電流密度為 1 A/cm2 時 J-V 特性的部分放大。(c) 以 1 MHz 頻率測量的 β-Ga2O3 SBD 的 C-V 特性。插圖: 器件在不同應力時間下提取的凈載流子濃度與耗盡區深度的關系。
DOI:
doi.org/10.1063/5.0260529
本文轉發自《亞洲氧化鎵聯盟》訂閱號
